| 일 | 월 | 화 | 수 | 목 | 금 | 토 |
|---|---|---|---|---|---|---|
| 1 | 2 | 3 | ||||
| 4 | 5 | 6 | 7 | 8 | 9 | 10 |
| 11 | 12 | 13 | 14 | 15 | 16 | 17 |
| 18 | 19 | 20 | 21 | 22 | 23 | 24 |
| 25 | 26 | 27 | 28 | 29 | 30 | 31 |
- 토익스피킹개정
- 파이썬
- 토익스피킹독학
- GSAT홍기찬
- 토익스피킹레벨
- GSAT기본서추천
- 기부좋은날체리
- 토익스피킹인강
- 한양대ERICA
- 체리플랫폼
- 반도체 취업
- 파이썬 함수
- 김변수와 시작하는 코딩생활
- 토익스피킹시험
- 김변수
- 토커비마이크
- 토커비
- GSAT인강
- 체리스쿨
- GSAT온라인스터디
- 파이썬 클래스
- 온라인봉사학교
- 엔지닉
- GSAT류병주
- 토커비토익스피킹
- 위포트
- 토익스피킹시험시간
- 토익스피킹무료
- GSAT문제집
- 블록체인기부
- Today
- Total
승이네 반도체
7/24 (일) 3. 박막/확산 장비 운영 본문

3. 박막/확산 장비 운영
준비하기
우리가 공부하고 있는 반도체 칩은 사람의 손톱보다 작고 얇은데요
이러한 반도체 칩을 수직으로 잘라서 고배율 전자현미경을 통해 들여다 보면 상상할 수 없을 만큼 미세하고, 수많은 층(Layer)이 고층 빌딩처럼 높고 견고하게 쌓여있는 모습을 볼 수 있습니다.
단결정 실리콘(Si) Wafer
- 박막(박막을 입히고) -> 포토공정(회로패턴을 그려넣음) -> 식각세정(불필요한 부분을 선택적으로 제거하는 식각과정과 세정과정을 여러번 반복해야합니다.)
박막(Thin Film)
- 기계가공으로는 실현 불가능한 1마이크로미터 이하의 얇은 막
박막 공정
-> 반도체 공정에서는 반도체가 원하는 전기적인 특성을 갖도록 하기 위해서 분자 도는 원자단위의 물질을 촘촘히 쌓게 됩니다. 워낙 두께가 낮기 때문에 Wafer위에 균일하게 박막을 형성시키기 위해서는 정교하고 세밀한 기술력이 팔요합니다.
학습내용
- 박막/확산 장비의 구성 이해하기
- 박막/확산 장비의 종류와 성능 파악하기
학습목표
- 장비 모델, 공정 모듈의 구성, 공동사양 등 식각(Etching) 장비별 규격서(Specification)를 작성할 수 있다.
- 박막/확산 장비와 부대설비들의 치수를 파악하여 레이아웃을 작성할 수 있다.
- 각종 유틸리티(Utility) 및 공정 가스의 제원을 파악하고 올바른 배관자재의 선택과 정확한 접속 위치를 알 수 있다.
1. 박막/확산 장비의 구성 이해하기(Etch 장비와 유사함)
1-1. PECVD의 구조
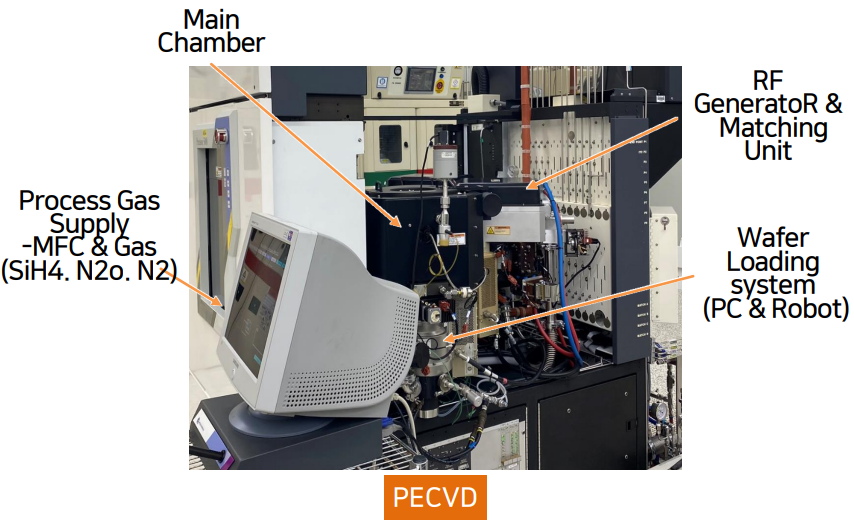
1. Process Gas Supply
- MFC(Mass Flow Controller) & Gas(SiH4, N2O, N2)
-> 얼마나 많은 유량으로 흘러가는지 컨트롤 해주는 것입니다.
2. Main Chamber
3. RF Generator & Matching Unit
-> 흘러가는 Gas와 RF Generator를 이용하여 Plasma를 만들고 반응시키고, Wafer 표면에 식각이 되어야 하는 식각반응물질을 반응을 시켜서 Etch를 시킵니다.
4. Wafer Loading System(PC & Robot)
-> PC에서 명령어 또는 마우스로 아이콘을 클릭하여 로봇을 구동시켜 Wafer를 Loading을 시키거나 공정이 끝난 Wafer를 UnLoding 해주는 것입니다.
1-2. RF Generator와 Plasma
Main Chamber
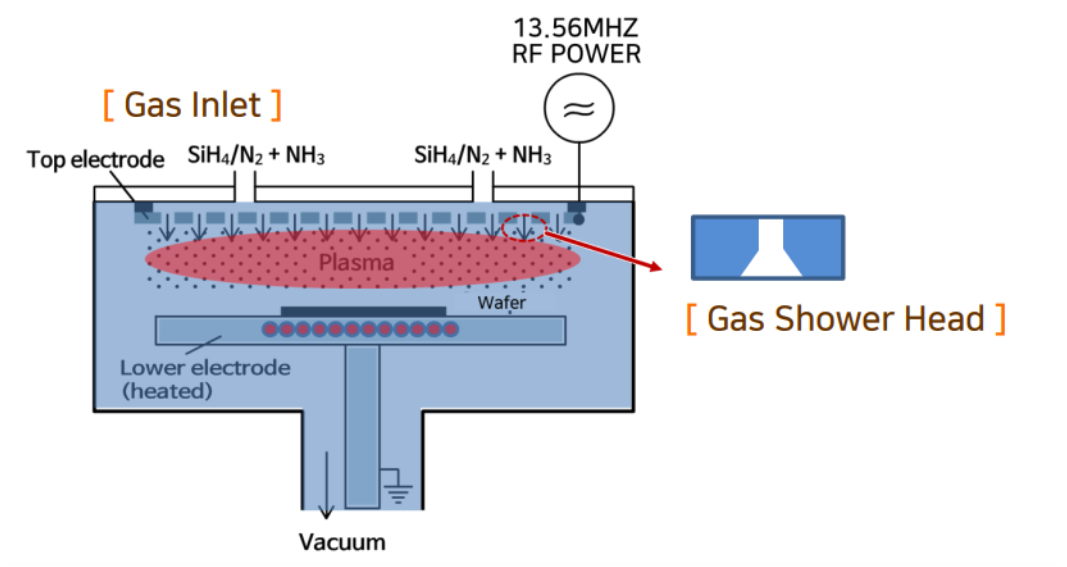
Gas Inlet (큰 구멍 2개)
-> Etch 장비에서 설명했듯 Main Chamber가 다음과 같이 있고, 중앙에 Wafer가 놓여있고 Head쪽에 Top부분에서 SiH4/N2 + NH3와 같은 가스들이 흘러 들어와 미세한 여러 개의 구멍을 통과하여 Gas들이 균일하게 전면적으로 살포가 되도록 구성이 되어있습니다.
Gas Shower Head (미세한 구멍 여러개)
- 균일한 Gas 분포 유도
- 증착의 Uniformity 영향
-> Gas들이 구멍쪽으로 너무 많이 몰리게 되면 증착이 많이 되어 두껍게 되고, Gas가 상대적으로 희박하게 된 곳은 박막이 얇게 증착이 되는 현상이 나타나기 때문에 그런 현상을 방지하기 위해 Shower Head로 Gas가 최대한 균일하게 퍼질 수 있도록 해줍니다.
=> 자세히 보면 Etch Chamber와 비슷하지만 Etch Chamber는 왼쪽 사이드에 Gas가 들어올 수 있는 구멍을 크게 만들어 Gas가 퍼지게 하고, CVD는 Chamber의 Top쪽에 Shower Head로 미세한 구멍을 뚫어주어 Gas를 균일하게 살포해 줍니다.
-> CVD는 그렇게 고진공을 사용하지 않지만, Etch는 반응식각을 위해 식각Gas만 들어가게 해줘야 하여 굉장히 고순도의 식각Gas만 흘러 들어가게끔 해줘야합니다.
-> 그래서 Etch에서는 10^-6의 Torr를 이용하여 고순도의 Chamber를 유지해야 하기 때문에 Gas가 들어가는 구멍이 크더라도 터보펌프가 그 역할을 충분히 해주지만, CVD는 그정도로 높은 진공도를 사용하지 않고, SiH4/N2, NH3(암모니아)와 같은 Gas들을 흘려주면서 동시에 증착을 해야합니다.
RF Generator : 고정주파수 13.56MHz RF전원장치
=> 반도체 CVD Etcher의 Main전원으로서 Chamber내에 Plasma 생성

- 주파수는 통신용 공공자원 국제협약에 따라서, 모든 나라가 합의한 주파수 분배방식에 따라서 사용하는 주파수를 분배
-> 주로 13.56MHz를 사용하며 RF Generator를 사용하게 되면 오른쪽 그림과 같이 Plasma가 발생하여 사용하는 기체에 따라 이온화되고, 또한 전자들이 역위가 되었다 다시 재결합하면서 Plasma 상태에서 여러가지 빛이 발광되는 현상을 볼 수 있습니다.
- 13.56MHz의 경우 파장특성상 안정성이 좋으므로 공정용에 적합(Etch, CVD에서 사용)
1-3. Process Gas Supply
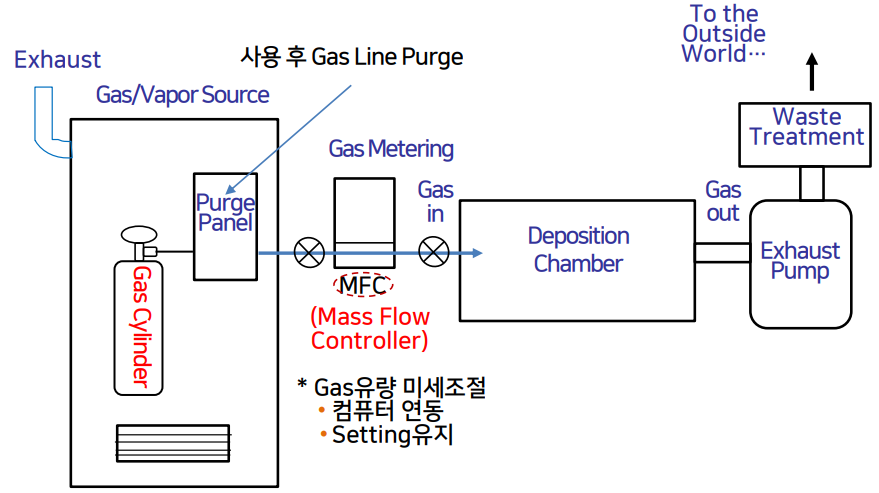
- Gas Cylinder: 가스 병(2m에 가까운 높이의 크기)
- Purge Panel: 가스를 Chamber로 공급해주기 전에 Gas라인에 불순물을 걸러주기 위한 Panel
(Vacuum Line이 연결되어 있음)
=> Gas Cabinet: Cylinder를 하나만 사용하는 경우가 있지만 경우에 따라 수소, 산소, SiNH4, NH3 등 여러 가지의 Gas를 사용할 수 있는데 그 중 하나만 Process Chamber로 지나가야 하는데 각각의 부분에 Valve를 하나씩 마련하여 필요한 부분의 Gas Cylinder Valve를 열어 지나갈 수 있도록 하고, 나머지 부분은 지나가지 못하게 하는 것
-> Gas Cabinet을 통해 Purge(깨끗해진)가 된 Line을 타고 Gas가 흘러 MFC로 들어가집니다.
- MFC(Mass Flow Controller): 적당한 유량의 흐르는 Gas가 Deposition Chamber로 흘러가게 해 주어야 합니다.
-> Gas Cylinder에서 고압용기이기 때문에 한꺼번에 많은 Gas가 흘러들어가게 방출이 되는데 MFC에서 조절이 됩니다. 그래야 Deposition Chamber에서 반도체에 필요한 박막을 적당한 두께로 공정을 유지할 수 있다.
- Exhaust Pump & Waste Treatment: 반응하고 남은 가스는 Exhaust Pump를 거쳐 배기장치인 Waste Treatment로 들어가 배출하게 됩니다.
- Scrubber: 굉장히 유독한 Gas를 대기로 보내기 전에 정화를 해줍니다.(정화장치)
-> 자동차의 머플러의 정화장치와 비슷하게 Scrubber를 거쳐 방출하게 됩니다.
MFC (Mass Flow Controller)
=> 컴퓨터와 연동하여 Gas 유량 미세조절 Setting 값 유지
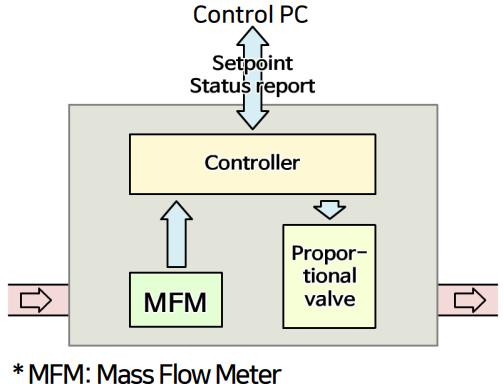
- MFC를 사용하여 자동화 장치를 이용하여 컴퓨터에 입력된 값으로 조절할 수 있어 Setting 값에 맞게 설정할 수 있다.
-> MFM과 Controller PC와 통신을 하여 얼마나 흐르고 있는지 체크를 하고, PC에서 연산하여 Set Point와 적정한지 확인을 하여 Valve의 Open 각도를 조절하여 적게 흐르거나 많이 흐르거나 조절할 수 있습니다.
1-4. Wafer Loading System
(박막/확산 장비도 Etch장비와 동일하게 생겼습니다.)
PC & Robot

박막/증착 장비의 전체적인 구성
- 노란 Cassette와 파란 Cassette
-> 파란 Cassette에 보통 원형의 Wafer가 25장 정도 장착합니다.
- 가운데 로봇트 암
-> 파란 Cassette에서 원형의 Wafer를 1, 2, 3, 4번 Chamber에 한장씩 나누어주어 동시에 공정을 진행합니다.
(Multi Chamber)
-> 공정이 끝나면 노란 Cassette로 이동시켜줍니다.
1-5. 설비관리와 Interlock
(모든 반도체용 설비는 굉장히 첨단 산업에 사용되는 설비이기 때문에 전부다 PC와 연동된다.)
Main 화면
- 설비의 전반적 상태 표시 - Standby Mode
-> 설비가 공정을 시작하거나 중간에 상태를 전반적으로 표시합니다.
부가화면
- 설비의 가동상태와 고장여부 표시 - Maintenance Mode
-> 설비가 가동 중이거나 대기 상태에 있을 때 설비에 여러 장치에 문제가 없는지 고장여부를 표시합니다.
부가화면에서의 특징: Setting 값과 Interlock
- Setting 값과 상태가 일치하지 않을 경우 설비는 작동을 멈춤(Vacuum(진공도), 온도, Gas 유량 등)
-> Setting 값과 잘 일치되는지 센서가 읽어주고, 컨트롤 해줍니다.
Main 화면: Standby Mode
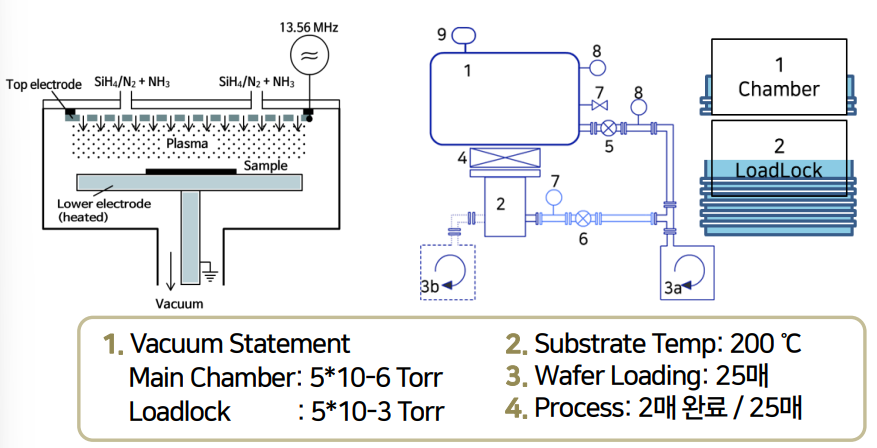
Etch와 유사하지만 왼쪽에 보면 Top electrode 부분에서 Shower Head가 사용이 되면서 electrode도 되고 Shower Head의 역할도 합니다.
-> Gas들이 미세한 구멍으로 균일하게 뿌려질 수 있도록 만들어 줍니다.
-> Vacuum의 상태, Wafer Loading의 상태, Gas Flow 상태를 잘 보여주고 확인할 수 있도록 합니다.
1. Vacuum Statement
Main Chamber: 5*10-6 Torr
Loadlock : 5*10-3 Torr
-> 메인 챔버에 가스를 흘려주고, 가스가 얼마나 흘러들어가고 있는지 확인할 수 있습니다.
2. Substrate Temp: 200도
-> 200도가 되고있는지확인할 수 있습니다.
3. Wafer Loading: 25매
-> Wafer에 Loading 되고 있는게 총 몇 장인지 확인할 수 있습니다.
4. Process: 2매 완료 / 25매
-> 완료된 Wafer가 몇장이 있는지 확인해 줍니다 확인할 수 있습니다.
부가화면: Process Gas - Maintenance Mode

반도체는 고순도의 Gas(99.9999%, 6 Nine의 순도)를 사용합니다.
국제 협약으로 산소의 경우 노란병, 질소는 회색병을 사용합니다.
set: 세팅해 놓은 값 [단위: cc/min]
act: 실제로 흐는 값 [단위: cc/min]
SCCM: Standard CC Min, 분당 흐르는 가스의 유량
1. O2 (set/act): 0 / 5 "leak or fail"
-> 1cc정도는 허용이 되지만 5cc는 Error가 납니다.
2. CF4 (set/act): 50 / 49 (Etching에 사용되는 Gas)
3. CHF3 (set/act): 50 / 49 (Etching에 사용되는 Gas)
4. N2 (set/act): 1500 / 1495
Main Chamber 오염상태 관리

Main Chamver에서 Etch 장비와 CVD 장비에서 오염관리 상태는 중요합니다.
Chamber의 벽에 Etching이나 박막/확산을 거친 후 찌꺼기 물질이 붙게 되는데 이런 찌꺼기들이 누적이 되면 다음 공정에서는 필요한 Gas에 의한 공정만 일어나야 하는데 Side Wall에 붙은 불순물과 반응을 하여 공정에 나쁜 영향을 미치게 됩니다.
-> 사람이 일일이 클리닝을 해야하며, 클리닝 할 때 많은 약품도 사용해야하고 정밀한 기기도 사용해야 하기 때문에 그 기간동안 사용을 못해 생산이 안돼 Loss가 발생합니다.
-> Chamber도 Spare Camber도 여러개 가지고 있어야 합니다. 그래서 기존에 사용하던 것을 클리닝 공장으로 보내거나 회사 내의 클리닝 시설로 보내 작업을 해야하고 Spare Chamber로 교체하여 공정은 공정대로 진행해야 합니다.
설비관리와 Process 불량
=> Chamber의 Condition 변화
Wafer의 형태를 보고 불량을 판단할 수 있는데, 실제로 Optical 매조먼트와 같은 광학기기를 사용하여 Chamber의 Condition 변화를 확인할 수 있습니다.
-> Wafer에 색이 다른현상이 발생할 수 있습니다. (사람 눈으로도 식별 가능)

-> 오른쪽 그림은 무지개처럼 색이 다른데 이런경우 박막의 두께가 모두 다르다는 것을 알 수 있습니다.
실제로 오랜시간 공정을 해본 경험자 Operater는 박막의 색깔만 보고도 두께가 얼마인지 인식을 할 수 있습니다.
-> 왼쪽 그림에서 빨간점으로 찍혀있는 것은 Setting 한 박막의 두께보다 너무 적게 증착이 되었거나, 너무 많게 증착이 되었거나 하면 컴퓨터에서 확인할 수 있습니다.
- PM이나 고장수리 이후 Process Chamber 내부의 분위기 변화
(Chamber Wall의 청결도, Seasoning 여부)
=> 내부부품의 고장
-> 불량의 원인이 어디인가? 고장은 설비관리에 의해 많이 발생하게 됩니다.
| MFC의 고장 | - 장기간 사용에 의한 내부 Flow Sensor의 오작동 (MFC도 기계의 일종이기 때문에 장기간 사용하다 보면 Gas가 지나가고 하면서 일정량의 Gas가 지나가야 하는데 안에서 Valve들이 마모가 되어 불량이 날 수 있습니다. -> MFC의 오작동에 의해 센서의 오작동, Valve의 오작동 -> 적당한 양의 유량이 흘러가지 않으면 공정이 미정확해집니다.(반도체는 미세함이 생명)) |
| Vacuum System 고장 | - Pump의 수명 - 오일의 수명 - 진공밸브의 O-ring(고무로 되어있음) 오염 (Etch 설비와 같듯이 장비정검일지를 잘 관리해야한다.) |
| Process Chamber의 오염 | - 장시간사용에 의한 오염 (Plasma가 일어나 공정이 끝나게 되면 남아있는 Gas들에 의해 오염이 있을 수 있습니다. -> 오염물질에 의해 원하지 않는 반응이 일어납니다.) - 작업자에 의한 오염 (특히 반도체 공정에서는 Particle관리에 민감합니다. 여성의 경우 파우더를 사용했을 때 무조건 경고를 받습니다.) |
=> Uniformity 불량과 Step Coverage 불량
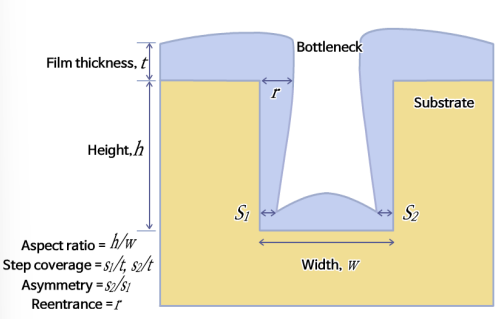
증착후 바닥부분 박막의 두께와 탑부분의 기판에 쌓여있는 비율 : s/t = 1
-> 가장 Small한 s, 가장 두꺼운 t쪽의 두께의 비율이 1대1이 될 때 Step Coverage가 가장 좋다고 볼 수 있는데 보통 증착하면 Top쪽은 두껍게 되고, 아랫쪽이나 Side Wall은 굉장히 얇게 됩니다.
-> 이런 일이 발생하지 않도록 설비를 정비하는 것이 중요합니다.
| 실제 탑 부분 | - 정상적으로 증착 |
| 측벽 | - 균일하지 않게 탑 부분보다 얇게 증착 |
-> Process 불량의 유형이 두가지 있습니다.
첫 번째로 Uniformity 불량
두 번째로 Step Coverage 불량
아랫쪽에 두께, 수직으로 볼때 사이드(Side Wall)의 두께, 맨 꼭대기의 두께가 다릅니다.
2. 박막/확산 장비의 종류와 성능 파악하기
2-1. 박막/확산의 종류와 특징
박막/확산 공정
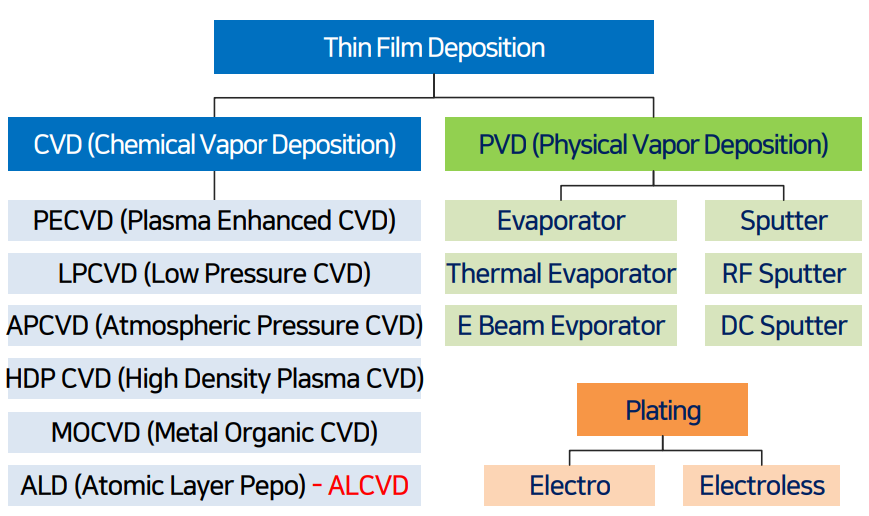
Thin Film Deposition
1. CVD(Chemical Vapor Deposition) - 화학 증착
2. PVD(Physical Vapor Deposition) - 물리 증착
3. Plating(도금)
PECVD (Plasma Enhanced CVD)
=> 강한 전압으로 야기된 Plasma를 이용하여 활성화시키고 기상으로 증착하는 장치
-> 가장 흔하게 사용되는 CVD입니다.
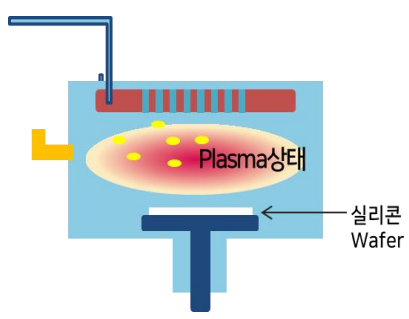
- Chamber내 Gas들의 화학반응물질로 박막을 증착하는 방법
- 낮은 온도에서 공정이 가능
-> 공정의 앞, 뒤로 다른 물질들이 섞여 있기 때문에 온도가 높아지면 앞, 뒤의 물질들이 영향을 받아 불량을 만들 수 있습니다.
| SiO2 증착 | SiH4(Gas) + N2(Gas) + N2O(Gas) -> SiO2(산화막) + H2(Gas) |
| SiN4 증착 | SiH4(Gas) + N2(Gas) + NH3(Gas) -> Si3N4(질화막) + H2(Gas) |
LPCVD (Low Pressure CVD)
=> 저압공정을 제외하고는 APCVD(대기압에서 사용하는 CVD)와 유사
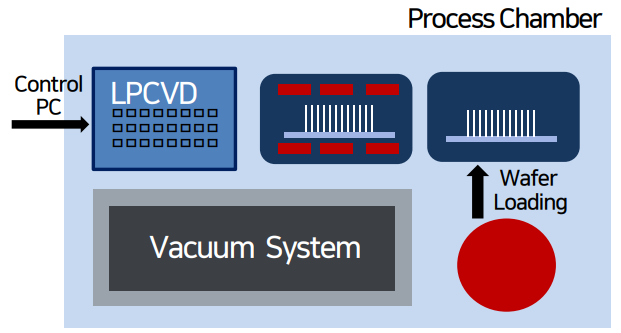
- LPCVD System은 주로 graphene(그래핀), oxides, nitrides, polysilicon, silicon 등을 증착
- Control PC, Process Chamber, Loading System으로 구성
-> 일반 Etch장비, 박막장비와 거의 구사한 구조로 되어있습니다.
APCVD(대기압(상압)에서 사용하는 CVD)
-> 컨베이어 장치같은 것이 달려있고 상부에 Gas가 들어가고 아랫쪽으로 Gas가 지나가면서 대기중에 있는 공기와 Process Gas가 공존하는 상태에서 Gas를 만듭니다.
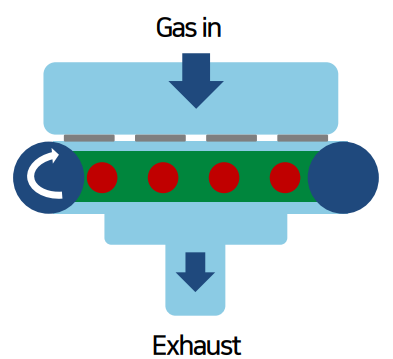
=> Advantages
- High throughput
- Good uniformity
- Handle large wafers
=> Disadvantages
- Fast gas flows
- Needs frequent cleaning(클리닝을 자주해야함)
PVD (Physical Vapor Deposition)
=> PVD는 화학반응없이 물리적인 방법으로 박막을 증착
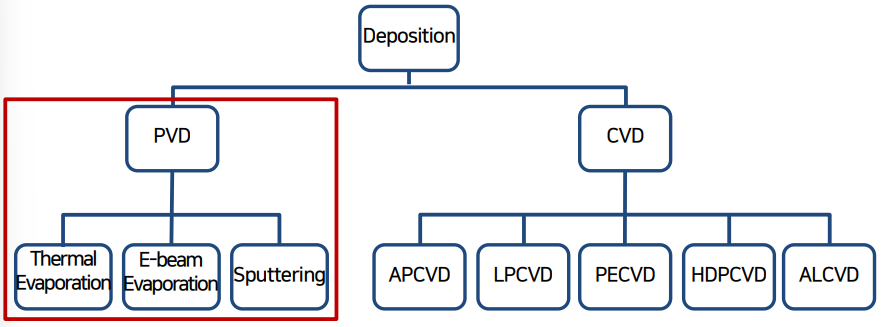
- 금속박막 증착에 주로 사용
-> 왼쪽은 PVD계열인데 3가지의 종류가 있습니다.
2-2. 박막/확산의 장치 기술
발생 Source에 따른 분류
| PVD (물리적 기상증착) | CVD (화학적 기상증착) |
| 물리적 기상 증착은 낮은 압력과 낮은 온도에서 진행 장점: 고품질 박막을 형성하고 불순물 오염 정도가 낮음 단점: 증착속도가 느리고 고가의 장비를 이용해야 함 |
가스의 화학 반응으로 형성된 입자들을 외부 에너지가 부여된 수증기 형태로 증착 - 화학적 기상 증착은 도체, 부도체, 반도체의 박막 증착에 모두 사용가능 장점: 접합성과 박막 품질이 좋음 |
PVD (물리적 기상증착)의 종류
| Thermal Evaporator 방식 (온도를 가해서 증착하는 방식) |
Sputtering 방식 (이온 스퍼터링 방식) |
증착시키고자 하는 물질의 보트에 올려두고 가열함으로써 증착물질을 증발시켜 기판에 증착하는 방식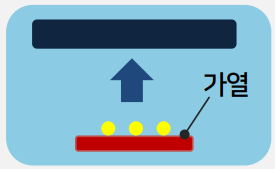 |
증착시키려는 물질의 Target을 Chamber 상단에 두고 이온을 이용하여 Target 물질을 Wafer에 증착시키는 방식 (Target에 있는 물질을 때려서 그림처럼 증착을 시키는 방식) 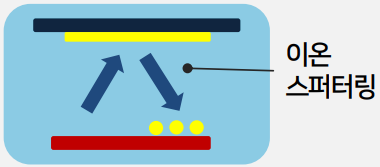 |
PVD (Physical Vapor Deposition)의 용도
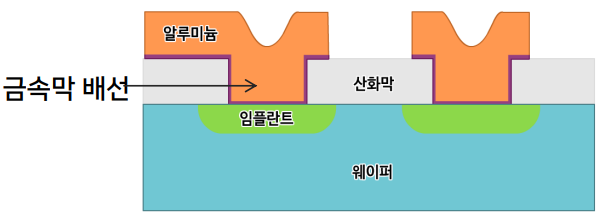
=> 금속박막 증착에 주로 사용
- 반도체의 회로 패턴을 따라 금속선(Metal Line)을 이어주는 공정
=> 대표적인 반도체용 금속 배선 재료: 알루미늄(Al)
- 산화막(Silicon Dioxide)과의 부착성이 좋고 가공성이 뛰어나기 때문
2-3. 산화/확산 공정
산화/확산 공정의 역할
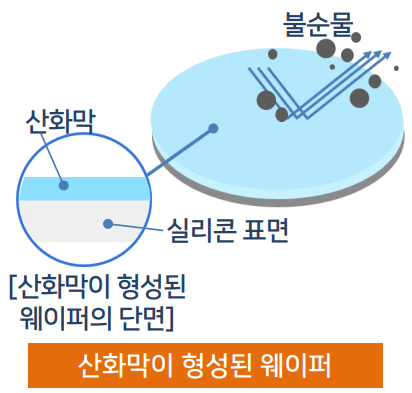
| 웨이퍼에 절연막 역할 | (이온주입공정) 확산 방지막 역할 |
| 산화막(SiO2)을 형성해 회로와 회로사이 누설전류차단 -> Si표면에 불순물이 흡착되지 않도록 산화막을 입혀 불순물을 방어해주는 역할 |
반도체 제조과정에서 전반적 보호막 역할 -> 파란색의 산화막으로 불순물을 방어해 주는 역할 |
건식산화와 습식산화
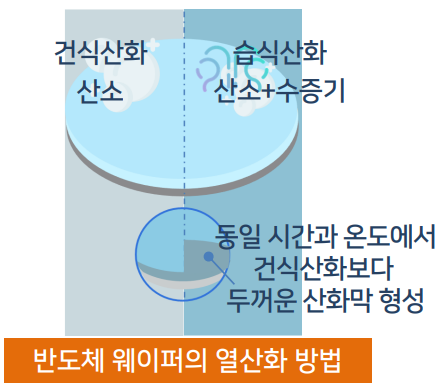
| 건식산화 | 습식산화 |
| 산소(O2)만을 이용 -> 산화막 성장속도가 느려 주로 얇은 막을 형성 |
산소와 용해도가 큰 수증기(H2O)를 함께 사용 -> 산화막 성장속도가 빠르고 보다 두꺼운 막을 형성 |
-> 둘다 똑같이 Wafer에 접촉을 시켜 증착을 시켜주는 방식입니다.
건식산화와 습식산화 Process
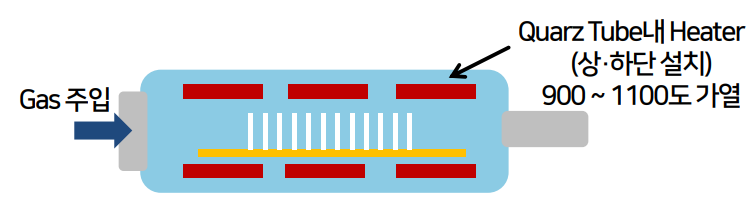
| Dry Oxidation Process | Wer Oxidation Process |
| Si (solid) + O2(산소) -> SiO2 (soild) | Si (solid) + 2H2O(수증기) -> SiO2 (soild) + 2H2 증가 |
-> 수증기(H2O)를 사용하느냐, 산소(O2)를 사용하느냐에 따라 다르고, 900도~1100도로 가열하는 것은 똑같은 방법을 사용합니다.
-> 이거를 사용하는 것을 퍼니스라 부르는데 퍼니스를 이용하여 건식 또는 습식공정을 이용하여 산화막을 증착하고 확산합니다.
심화학습
오늘 학습한 내용을 바탕으로 박막/확산 증착(Deposition)의 두 가지 방법인 물리적 기상증착방법과 화학적 기상증착방법을 비교하여 한 마디로 정의한다면, 어떻게 정의할 수 있을까요?
증착(Deposition)
Wafer위에 원하는 분자 또는 원자 단위의 물질을 박막에 두께를 입혀 전기적특성을 갖게되는 과정을 증착이라 합니다.
물리적 기상증착방법(PVD, Pysical Vapor Deposition)
- 금속 박막의 증착에 주로 사용되는데 화학반응이 수반되지 않습니다.
화학적 기상증착방법(CVD, Chemical Vapor Deposition)
- 가스의 화학반응으로 형성된 입자들을 외부에너지가 수증기 형태로 쏘아 증착시키는 방법입니다.
이는 도체, 부도체, 반도체의 박막증착에 모두 활용될 수 있습니다.
=> 반도체 공정에서의 증착은 CVD를 주로 사용합니다.
- 사용하는 외부 에너지에 따라 열 CVD, 플라즈마 CVD, 광 CVD 등으로 세분화됩니다.
플라즈마 CVD
- 저온에서 형성 가능
- 두께의 균일도 조절 가능
- 대량 처리 가능
=> 최근에 가장 많이 이용되고 있습니다.
학습정리
1. 박막/확산 장비의 구성 이해하기
- 박막/확산 장비는 반도체 제조공정에서 증착 공정장비로서 Vacuum System과 RF Power를 이용하거나 900도~1100도의 고온을 가하여 막을 증착 또는 반응 확산을 일으키는 장비임
- 핵심구성은 Vacuum System, Process Chamber, RF Generator, Heater로 구성됨
2. 박막/확산 장비의 종류와 성능 파악하기
- CVD는 화학적 반응을 이용하는 장비이고, 절연막을 증착하는데 사용됨
- PVD는 물리적 현상을 이용하여 박막을 증착하는 장비로서 주로 금속 배선공정에 사용됨




